课程介绍
感谢您使用电巢APP,PC端建议使用Google Chrome浏览器进行观看。
讲师介绍:
李晓东老师|EDA365 Cadence Allegro论坛特邀版主

电巢学堂特邀讲师
前华为公司七级技术专家
无线微波首席技术规划专家
20年光网络、微波毫米波产品研发经验
工作经历
1999/7~2019/12,在华为公司研发体担任硬件工程师、系统工程师、首席技术规划专家,先后从事光网络产品,数据通信产品,微波毫米波产品,5G产品研发工作;
2020年8月加入电巢科技,主要负责微波毫米波、无线通信系统设计的技能提升的教学与培训。
主题背景:
网上传言,菊厂芯片遇到的“卡脖子”的问题,主要依靠芯片堆叠技术,也就是“3D封装技术”来解决,就是把低工艺制程的芯片堆叠起来,来追赶高工艺制程芯片的高性能,2023年实现手机的“王者归来,一飞冲天”,那么用这个技术是否真正可以实现这个目标呢?
本次直播将从技术和产业视角为大家介绍芯片的2.5D、3D封装技术的由来,关键的设计,与芯片巨头的玩法,为大家解读这个技术是否能帮助菊厂实现这个目标?
直播要点
为何要进入到2.5D、3D封装
芯片2.5D、3D封装概述
芯片巨头们2.5D/3D封装的技术布局



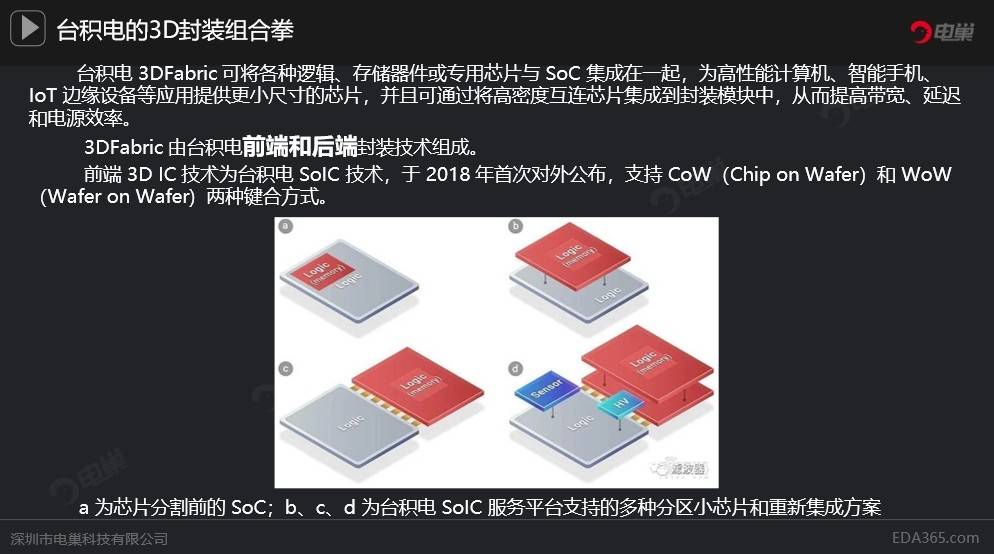

适合对象:
硬件工程师
无线电工程师
质量/可靠性工程师
电气工程、电力电子相关专业学生


